| 纯化学刻蚀、纯物理刻蚀及反应式离子刻蚀介绍 | 您所在的位置:网站首页 › 纯物理 在线 › 纯化学刻蚀、纯物理刻蚀及反应式离子刻蚀介绍 |
纯化学刻蚀、纯物理刻蚀及反应式离子刻蚀介绍
|
纯化学刻蚀、纯物理刻蚀及反应式离子刻蚀 刻蚀有三种:纯化学刻蚀、纯物理刻蚀,以及介于两者之间的反应式离子刻蚀(ReactiveIonEtch,RIE)。 纯化学刻蚀包括湿法刻蚀和遥控等离子体光刻胶去除。纯化学刻蚀中没有物理轰击,由化学反应移除物质。纯化学刻蚀的速率根据工艺需要可以很高也可以很低。纯化学刻蚀一定会有等向性刻蚀轮廓,因此当图形尺寸小于3um时,就无法使用纯化学刻蚀进行薄膜图形化技术。 由于纯化学刻蚀具有很好的刻蚀选择性,所以纯化学刻蚀通常用在剥除工艺上。例如,去光刻胶、去氮化硅、垫基氧化层、屏蔽氧化层和牺牲氧化层等。遥控等离子体(RP)刻蚀是在远端反应室中利用等离子体产生自由基,再将自由基送入反应室和晶圆产生反应,因此属于纯化学刻蚀。 氯轰击属于纯物理刻蚀,广泛使用在电介质溅射回刻削平开口部分,以利于后续的空隙填充。氯轰击也用于金属PVD前的清洗过程,用于移除氧化物以减少接触电阻。氯是一种惰性气体,制造中不会产生化学反应。材料受氯离子轰击后从表面脱离,如用一只锤子把材料从表面敲击移除一样。 纯物理刻蚀的速率一般很低,主要取决于离子轰击的流量和能量。因为离子会轰击并移除任何与衬底接触的材料,所以纯物理刻蚀的选择性很低。等离子体刻蚀中,离子轰击的方向通常和晶圆表面互相垂直。所以纯物理刻蚀主要是朝垂直方向刻蚀,它是一种非等向性刻蚀过程。 反应离子蚀刻(RIE)的名称可能是有些误导。这种类型的蚀刻工艺的正确名称应为离子辅助蚀刻,因为在此蚀刻工艺中的离子不一定有化学反应。例如在许多情况下氯离子被用来增加离子轰击。而作为一种惰性原子,氯离子是没有化学反应的。大多数蚀刻制程中的化学活性物是中性的自由基。 在半导体蚀刻加工等离子体中,中性的自由基的浓度比离子浓度高得多。这是因为电离活化能明显高于解离的活化能,而物种浓度与活化能指数相关。然而,RIE这个词在半导体业界已被用了很长时间,可能没有人会改变它。下图显示离子辅助蚀刻的原理与早期实验的结果。 首先将XeF2气体单独由闭锁阀门注入。XeF2是一种不稳定的气体。徹是一种惰性气体,所以不会与其他原子形成化学键。干法化学刻蚀中通常用于输送氟自由基。当XeF2接触到已加热的单晶硅时,就会分解并释放出两个氟自由基。因为氟自由基只有一个不成对的电子,所以能从其他原子获得一个电子,在化学上很容易起反应。氟会与样品表面的硅反应形成易挥发性的四氟化硅(SiF4)。下图中的测量结果表明了这种纯化学刻蚀的刻蚀速率很低。
接着开启氯离子枪。结合了物理的离子束轰击和氟自由基的化学刻蚀,硅的刻蚀速率明显增加。当关闭阀门停止输送XeF2气流后,硅就单独由氯离子溅射刻蚀。这是一种纯物理刻蚀,刻蚀速率比使用XeF2气流的纯化学刻蚀还要慢。 审核编辑:刘清 声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。 举报投诉 PVD PVD +关注关注 4文章 46浏览量 16814 反应离子刻蚀 反应离子刻蚀 +关注关注 0文章 4浏览量 1782原文标题:半导体行业(一百五十六)之刻蚀工艺(七) 文章出处:【微信号:FindRF,微信公众号:FindRF】欢迎添加关注!文章转载请注明出处。 收藏 人收藏扫一扫,分享给好友 复制链接分享 评论发布评论请先 登录 相关推荐 半导体行业之刻蚀工艺 等离子体图形化刻蚀过程中,刻蚀图形将影响刻蚀速率和刻蚀轮廓,称为负载效应。负载效应有两种:宏观负载效应和微观负载效应。 发表于 02-08 09:41 •2396次阅读 干法刻蚀常用设备的原理及结构 干法刻蚀技术是一种在大气或真空条件下进行的刻蚀过程,通常使用气体中的离子或化学物质来去除材料表面的部分,通过掩膜和刻蚀参数的调控,可以实现各 振奋!中微半导体国产5纳米刻蚀机助力中国芯
就能对层上的特定部分进行选择性地移除。在有的情况中,罩的材料为光阻性的,这和光刻中利用的原理类似。而在其他情况中,刻蚀罩需要耐受某些化学物质,氮化硅就可以用来制造这样的“罩”。“干法”(等离子)
发表于 10-09 19:41
【转帖】干法刻蚀的优点和过程
缓冲氧化物刻蚀剂中是溶解二氧化硅的成分,并转化为可水冲洗的成分。形成反应的能量来自缓冲氧化物刻蚀溶液的内部或外部加热器。等离子体刻蚀机要求相同的元素:
发表于 12-21 13:49
请教碳化硅刻蚀工艺
最近需要用到干法刻蚀技术去刻蚀碳化硅,采用的是ICP系列设备,刻蚀气体使用的是SF6+O2,碳化硅上面没有做任何掩膜,就是为了去除SiC表面损伤层达到表面改性的效果。但是实际刻蚀过程中
发表于 08-31 16:29
AOE刻蚀系统
AOE刻蚀氧化硅可以,同时这个设备可以刻蚀硅吗?大致的气体配比是怎样的,我这里常规的刻蚀气体都有,但是过去用的ICP,还没有用过AOE刻蚀硅,请哪位大佬指点一下,谢谢。
发表于 10-21 07:20
干法刻蚀原理
干法刻蚀原理
刻蚀作用:去除边缘PN结,防止上下短路。干法刻蚀原理:利用高频辉光放电反应,使CF4气体激活成活性粒子,这些活性
发表于 07-18 11:28
•5583次阅读
干法刻蚀之铝刻蚀的介绍,它的原理是怎样的
在集成电路的制造过程中,刻蚀就是利用化学或物理方法有选择性地从硅片表面去除不需要的材料的过程。从工艺上区分,刻蚀可以分为湿法刻蚀和干法
发表于 12-29 14:42
•8403次阅读
振奋!中微半导体国产5纳米刻蚀机助力中国芯
就能对层上的特定部分进行选择性地移除。在有的情况中,罩的材料为光阻性的,这和光刻中利用的原理类似。而在其他情况中,刻蚀罩需要耐受某些化学物质,氮化硅就可以用来制造这样的“罩”。“干法”(等离子)
发表于 10-09 19:41
【转帖】干法刻蚀的优点和过程
缓冲氧化物刻蚀剂中是溶解二氧化硅的成分,并转化为可水冲洗的成分。形成反应的能量来自缓冲氧化物刻蚀溶液的内部或外部加热器。等离子体刻蚀机要求相同的元素:
发表于 12-21 13:49
请教碳化硅刻蚀工艺
最近需要用到干法刻蚀技术去刻蚀碳化硅,采用的是ICP系列设备,刻蚀气体使用的是SF6+O2,碳化硅上面没有做任何掩膜,就是为了去除SiC表面损伤层达到表面改性的效果。但是实际刻蚀过程中
发表于 08-31 16:29
AOE刻蚀系统
AOE刻蚀氧化硅可以,同时这个设备可以刻蚀硅吗?大致的气体配比是怎样的,我这里常规的刻蚀气体都有,但是过去用的ICP,还没有用过AOE刻蚀硅,请哪位大佬指点一下,谢谢。
发表于 10-21 07:20
干法刻蚀原理
干法刻蚀原理
刻蚀作用:去除边缘PN结,防止上下短路。干法刻蚀原理:利用高频辉光放电反应,使CF4气体激活成活性粒子,这些活性
发表于 07-18 11:28
•5583次阅读
干法刻蚀之铝刻蚀的介绍,它的原理是怎样的
在集成电路的制造过程中,刻蚀就是利用化学或物理方法有选择性地从硅片表面去除不需要的材料的过程。从工艺上区分,刻蚀可以分为湿法刻蚀和干法
发表于 12-29 14:42
•8403次阅读
 关于微技术中硅反应离子刻蚀的研究
等离子体辅助刻蚀的基础简单;使用气体辉光放电来离解和离子化相对稳定的分子,形成化学反应性和离子性物质,并选择
发表于 02-14 15:22
•1582次阅读
关于微技术中硅反应离子刻蚀的研究
等离子体辅助刻蚀的基础简单;使用气体辉光放电来离解和离子化相对稳定的分子,形成化学反应性和离子性物质,并选择
发表于 02-14 15:22
•1582次阅读
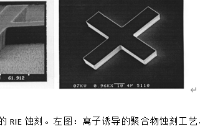 干法刻蚀工艺介绍
刻蚀室半导体IC制造中的至关重要的一道工艺,一般有干法刻蚀和湿法刻蚀两种,干法刻蚀和湿法刻蚀一个显著的区别是各向异性,更适合用于对形貌要求较
发表于 06-13 14:43
•6次下载
湿法刻蚀工艺的流程包括哪些?
湿法刻蚀利用化学溶液溶解晶圆表面的材料,达到制作器件和电路的要求。湿法刻蚀化学反应的生成物是气体、液体或可溶于刻蚀剂的固体。
干法刻蚀工艺介绍
刻蚀室半导体IC制造中的至关重要的一道工艺,一般有干法刻蚀和湿法刻蚀两种,干法刻蚀和湿法刻蚀一个显著的区别是各向异性,更适合用于对形貌要求较
发表于 06-13 14:43
•6次下载
湿法刻蚀工艺的流程包括哪些?
湿法刻蚀利用化学溶液溶解晶圆表面的材料,达到制作器件和电路的要求。湿法刻蚀化学反应的生成物是气体、液体或可溶于刻蚀剂的固体。
 刻蚀分为哪两种方式 刻蚀的目的和原理
刻蚀(Etching)的目的是在材料表面上刻出所需的图案和结构。刻蚀的原理是利用化学反应或物理过程,通过移除材料表面的原子或分子,使材料发生形貌变化。
刻蚀分为哪两种方式 刻蚀的目的和原理
刻蚀(Etching)的目的是在材料表面上刻出所需的图案和结构。刻蚀的原理是利用化学反应或物理过程,通过移除材料表面的原子或分子,使材料发生形貌变化。
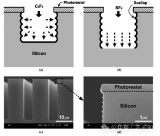
|
【本文地址】